在点胶装片前,基板上如果存在污染物,银胶容易形成圆球状,降低芯片粘结度。因此,在DB工艺前,需要进行等离子处理,提高基板表面的亲水性和粗糙度,有利于银胶的平铺及芯片粘贴,提高封装的可靠性和耐久性。在提升点胶质量的同时可以节省银胶使用量,降低成本。
在Flip Chip(FC)倒装工艺中,将称为“焊球(Solder Ball)”的小凸块附着在芯片焊盘上。其次,将芯片顶面朝下放置在基板上,完成芯片与基板的连接后,通常需要在在芯片与基板之间使用填充胶进行加固,以提高倒装工艺的稳定性。
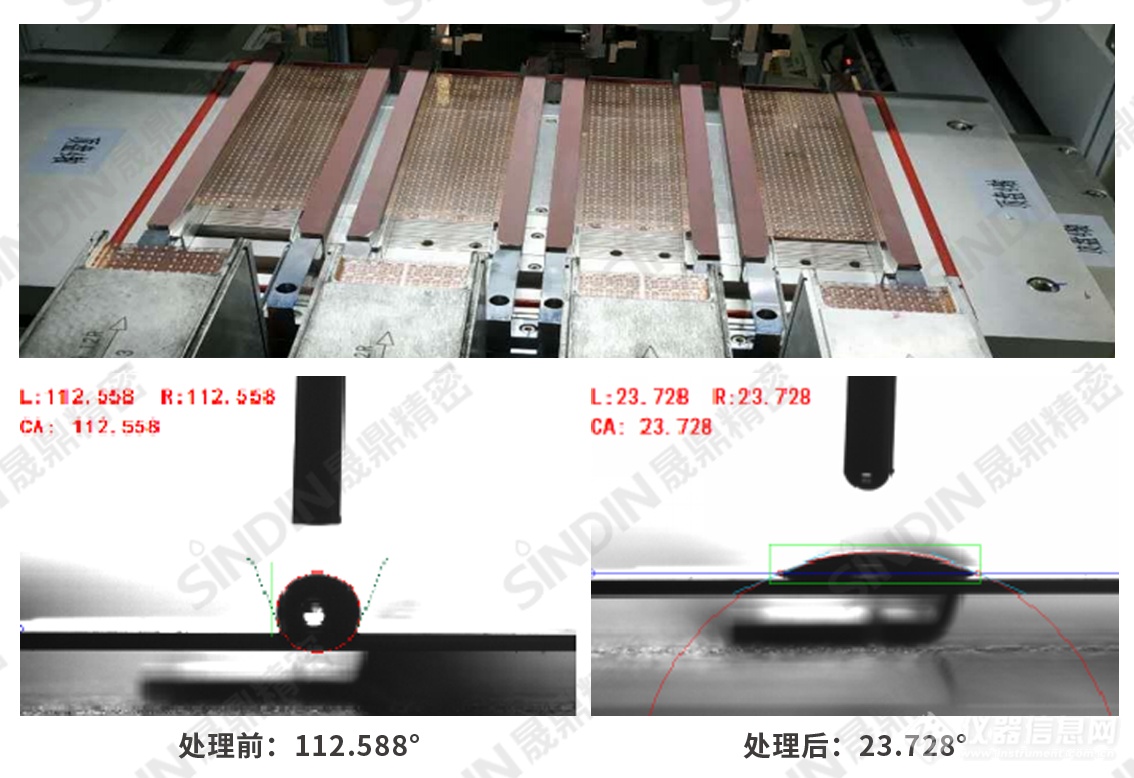
通过等离子清洗可以改善芯片和基板表面润湿性,提高其表面附着力,进而影响底部填充胶的流动性,使填充胶可以更好地与基板和芯片粘结,从而达到加固的目的,提高倒装工艺可靠性。
Flip Chip (FC)倒装工艺等,能够大幅提高其表面润湿性,保证后续工艺质量,从而提高封装工艺的可靠性。

可兼容多种弹匣尺寸,可自动调节宽度,提升效率并具备弹匣有无或装满报警提示功能
LED行业:点银胶、固晶、引线键合前、LED封装等工序中可提高粘和强度,减少气泡,提高发光率
PCB/FPC行业:金属键合前、塑封前、底部填充前处理、光刻胶去除、基板表面活化、镀膜,去除静电及有机污染物
![]()
![]()
鑫图客户成就 北京艾锐科技发布自研商用转盘共聚焦系统( 400BSI V3在先进显微仪器整合中的
实验室搬迁如何避开“致命雷区”?这场线上会议为你拆解安全、合规、数据三大核心难题
天津市市场监督管理委员会公开征求《压力显示仪校准规范》等2项地方计量技术规范意见
安徽省市场监管局计量处发布《可穿戴体温计校准规范》等2项地方计量技术规范
国家认监委秘书处印发《〈国家认监委关于加强认证规则管理的公告〉实施指南》
1040万!山东大学和西安建筑科技大学多功能热流固耦合岩石真三轴测试系统等采购项目
1254万!新乡医学院生物医学前沿研究中心大型仪器设备更新项目(超高速全光谱流式细胞分选分析系统)项目







